
技术咨讯
半导体晶圆制程使用热处理炉的滑移位错问题
时间: 2020-06-02 16:38:38
浏览次数:
作为半导体基板来使用的单晶硅晶圆承受的高温的热能,而导致硅结晶构造偏移数公厘到数公分的长度,与支撑构件接触的部分会发生被称为滑移位错。
热处理技术被用于各种半导体制程中,已成为基本且重要的技术。对于作为半导体基板来使用的单晶硅晶圆,为了改质结晶质量、扩散杂质、或在表层部分形成薄膜构造等目的,而实施热处理。被载置于这样的支撑构件上的单晶硅晶圆,例如在氩气或氧气的氛围下进行热处理。已知在该热处理时,从与支撑构件接触的部分会发生被称为滑移位错転位,slip dislocat1n)的缺陷。滑移位错是由于下述原因所形成的缺陷:以单晶硅晶圆接触到支撑构件时所产生的机械性损伤作为起点,再加上晶圆本身的重量所导致的应力、热变形时所产生的应力,进一步加上所承受的高温的热能,而导致硅结晶构造偏移数公厘到数公分的长度。
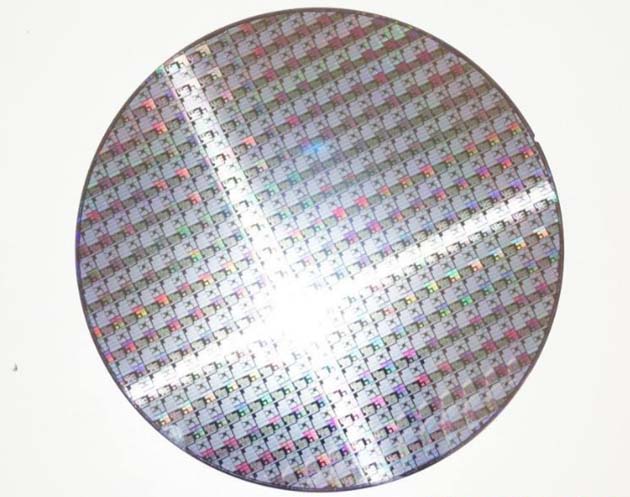 作为用于实施热处理的热处理装置,广泛使用一种将多片晶圆隔开规定的间隔并且同时处理这些晶圆的批次式的装置。特别是,以将晶圆支撑成水平的状态下将晶圆纵向配置的类型,被称为纵型炉。另外,以接近垂直的角度竖立的状态下横向配置的类型,被成为横型炉。
作为用于实施热处理的热处理装置,广泛使用一种将多片晶圆隔开规定的间隔并且同时处理这些晶圆的批次式的装置。特别是,以将晶圆支撑成水平的状态下将晶圆纵向配置的类型,被称为纵型炉。另外,以接近垂直的角度竖立的状态下横向配置的类型,被成为横型炉。
随着近年来晶圆的大直径化,大多采用纵型炉。在热处理炉内支撑晶圆的支撑构件被称为晶舟,一般是采用石英制(石英晶舟)、或在SiC(碳化硅)材料的表面上实施了CVD-SiC覆盖(化学气相沉积碳化硅覆盖)而成的SiC制晶舟(SiC晶舟)。特别是在高温热处理中,对热的耐久度高的SiC制的支撑构件被广泛使用。虽然支撑构件的形状有各种形状,但是作为纵型炉用的支撑构件,一般是使用下述形状的支撑构件:利用两片板状构件(顶板和底板),将三根或四根垂直的支柱连结在一起,且在支柱的一部分形成有水平方向的沟。晶圆被载置且支撑于这些沟的水平面上。 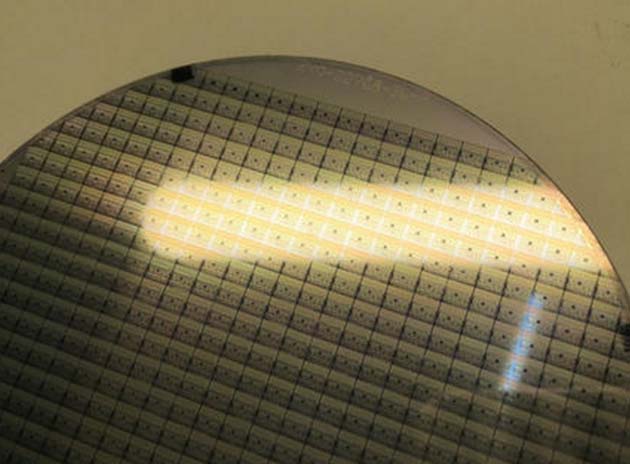 在使用了纵型炉的情况下,相较于横型炉,由于晶圆本身的重量被分散,晶圆面内的热分布的均匀性也较好,因此滑移位错有被限制住的倾向。但是,即便是在使用了纵型炉的情况下,特别是在使用了SiC制的支撑构件的情况下,有时仍然会发生许多滑移位错。进一步,即便在所使用的支撑构件是基于同样的设计并制作而成的情况下,各个支撑构件的滑移位错的发生状况相异,且即便在支撑构件的使用初期没有发生滑移位错的情况下,由于长时间使用,支撑构件也有可能发生滑移位错。
在使用了纵型炉的情况下,相较于横型炉,由于晶圆本身的重量被分散,晶圆面内的热分布的均匀性也较好,因此滑移位错有被限制住的倾向。但是,即便是在使用了纵型炉的情况下,特别是在使用了SiC制的支撑构件的情况下,有时仍然会发生许多滑移位错。进一步,即便在所使用的支撑构件是基于同样的设计并制作而成的情况下,各个支撑构件的滑移位错的发生状况相异,且即便在支撑构件的使用初期没有发生滑移位错的情况下,由于长时间使用,支撑构件也有可能发生滑移位错。
将多片半导体晶圆各自水平地载置于以碳化硅覆盖的支撑构件上,并在纵型热处理炉内实行热处理,其中,该热处理方法的特征在于,将所述支撑构件,在一条件或二条件中的任一种条件的热处理中持续使用了一定期间后,在所述一条件和二条件中的另一种条件的热处理中持续使用一定期间,以此方式将所述支撑构件与热处理条件切换来进行热处理;并且,所述一条件的热处理,是以1000°c以上的温度,在含有稀有气体且不含有氧气的氛围下进行的热处理;所述二条件的热处理,是以1000°c以上的温度,在含有氧气且不含有稀有气体的氛围下进行的热处理。
由于是将支撑构件,在一条件(1000°C以上,含有稀有气体且不含有氧气的氛围)、或二条件(1000°c以上,含有氧气且不含有稀有气体的氛围)中的任一种条件的高温热处理中持续使用了一定期间之后,在所述一条件和二条件中的另一种条件的高温热处理中持续使用一定期间,以此方式将支撑构件与热处理条件切换来进行热处理,因此,能够限制用于载置半导体晶圆的支撑构件的表面的形状变化,从而能够以低成本来限制滑移位错。纵型热处理炉具有反应室,在反应室的内部配置有支撑构件(晶圆晶舟)。在反应室的周围设置有加热器。
能将多片半导体晶圆W各自水平地载置于支撑构件上。例如,能够在构成支撑构件的支柱的侧面,沿水平方向形成沟槽,并将该沟槽的下表面设为晶圆支撑面。晶圆支撑面例如能设成:形成于圆柱形的支柱上的半圆形的支撑面、或是形成于方柱形状的支柱上的长方形的支撑面。支撑构件,至少在该晶圆支撑面上被耐热性高的Si C覆盖,从而能够防止在热处理中发生晶圆的金属污染的情况。SiC例如是以CVD(化学气相沉积)来覆盖。
支撑构件以能从纵型中取出的方式来设置。因此,可将支撑构件13在载置有晶圆W的状态下配置于纵型中,也能将支撑构件从纵型炉中取出。
热处理时,一边经由气体导入管将气体导入反应室,一边通过加热器来加热晶圆W。被导入的气体从上方向下方流动并从气体排气管15被排出至外部。
这种热处理方法的热处理条件中,有一条件和二条件,且这些条件与所使用的支撑构件的组合会被决定。具体而言,以下述方式来切换支撑构件与热处理条件:在一条件或二条件中的任一种条件的高温热处理中,持续使用了支撑构件—定期间后,在另一种条件的热处理中,持续使用支撑构件—定期间。此时,在相同的纵型炉中,可以一边持续使用相同的支撑构件一边改变热处理条件,由此来切换支撑构件与热处理条件。或者,也可以一边利用相同的热处理条件持续进行热处理,一边将所使用的支撑构件更换成已在其他条件下被使用过的支撑构件,由此来切换支撑构件与热处理条件。像这样,通过切换支撑构件与热处理条件来实行热处理,能够如以下详述地那样限制滑移位错。
一条件的热处理,是以1000°C以上的温度,在含有稀有气体且不含有氧气的氛围下进行的热处理。二条件的热处理,是以1000°c以上的温度,在含有氧气且不含有稀有气体的氛围下进行的热处理。一条件的氛围的代表例是氩气氛围(Ar气体100% )。二条件的氛围的代表例是氧气氛围(O2气体100%)。热处理温度若是不到1000°C,由于滑移位错的发生会被限制,因此无法充分获得本发明的效果。另一方面,通过设成1350°C以下的温度,能够切实地防止滑移位错大幅地增加,因此优选。
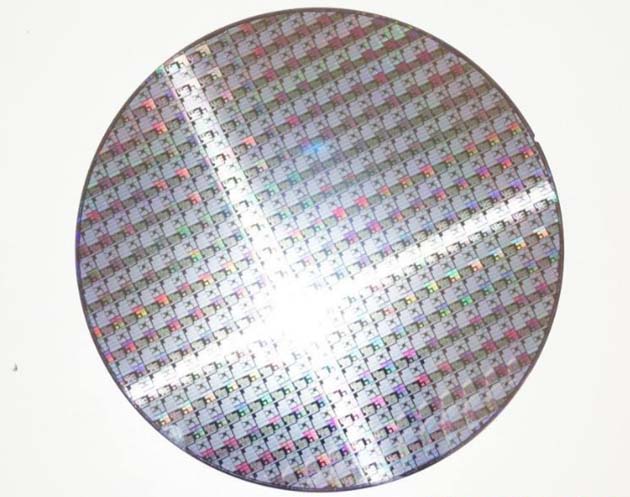
随着近年来晶圆的大直径化,大多采用纵型炉。在热处理炉内支撑晶圆的支撑构件被称为晶舟,一般是采用石英制(石英晶舟)、或在SiC(碳化硅)材料的表面上实施了CVD-SiC覆盖(化学气相沉积碳化硅覆盖)而成的SiC制晶舟(SiC晶舟)。特别是在高温热处理中,对热的耐久度高的SiC制的支撑构件被广泛使用。虽然支撑构件的形状有各种形状,但是作为纵型炉用的支撑构件,一般是使用下述形状的支撑构件:利用两片板状构件(顶板和底板),将三根或四根垂直的支柱连结在一起,且在支柱的一部分形成有水平方向的沟。晶圆被载置且支撑于这些沟的水平面上。
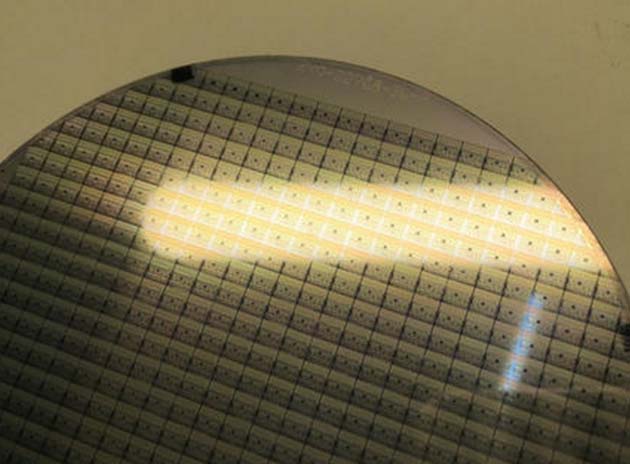
将多片半导体晶圆各自水平地载置于以碳化硅覆盖的支撑构件上,并在纵型热处理炉内实行热处理,其中,该热处理方法的特征在于,将所述支撑构件,在一条件或二条件中的任一种条件的热处理中持续使用了一定期间后,在所述一条件和二条件中的另一种条件的热处理中持续使用一定期间,以此方式将所述支撑构件与热处理条件切换来进行热处理;并且,所述一条件的热处理,是以1000°c以上的温度,在含有稀有气体且不含有氧气的氛围下进行的热处理;所述二条件的热处理,是以1000°c以上的温度,在含有氧气且不含有稀有气体的氛围下进行的热处理。
由于是将支撑构件,在一条件(1000°C以上,含有稀有气体且不含有氧气的氛围)、或二条件(1000°c以上,含有氧气且不含有稀有气体的氛围)中的任一种条件的高温热处理中持续使用了一定期间之后,在所述一条件和二条件中的另一种条件的高温热处理中持续使用一定期间,以此方式将支撑构件与热处理条件切换来进行热处理,因此,能够限制用于载置半导体晶圆的支撑构件的表面的形状变化,从而能够以低成本来限制滑移位错。纵型热处理炉具有反应室,在反应室的内部配置有支撑构件(晶圆晶舟)。在反应室的周围设置有加热器。
能将多片半导体晶圆W各自水平地载置于支撑构件上。例如,能够在构成支撑构件的支柱的侧面,沿水平方向形成沟槽,并将该沟槽的下表面设为晶圆支撑面。晶圆支撑面例如能设成:形成于圆柱形的支柱上的半圆形的支撑面、或是形成于方柱形状的支柱上的长方形的支撑面。支撑构件,至少在该晶圆支撑面上被耐热性高的Si C覆盖,从而能够防止在热处理中发生晶圆的金属污染的情况。SiC例如是以CVD(化学气相沉积)来覆盖。
支撑构件以能从纵型中取出的方式来设置。因此,可将支撑构件13在载置有晶圆W的状态下配置于纵型中,也能将支撑构件从纵型炉中取出。
热处理时,一边经由气体导入管将气体导入反应室,一边通过加热器来加热晶圆W。被导入的气体从上方向下方流动并从气体排气管15被排出至外部。
这种热处理方法的热处理条件中,有一条件和二条件,且这些条件与所使用的支撑构件的组合会被决定。具体而言,以下述方式来切换支撑构件与热处理条件:在一条件或二条件中的任一种条件的高温热处理中,持续使用了支撑构件—定期间后,在另一种条件的热处理中,持续使用支撑构件—定期间。此时,在相同的纵型炉中,可以一边持续使用相同的支撑构件一边改变热处理条件,由此来切换支撑构件与热处理条件。或者,也可以一边利用相同的热处理条件持续进行热处理,一边将所使用的支撑构件更换成已在其他条件下被使用过的支撑构件,由此来切换支撑构件与热处理条件。像这样,通过切换支撑构件与热处理条件来实行热处理,能够如以下详述地那样限制滑移位错。
一条件的热处理,是以1000°C以上的温度,在含有稀有气体且不含有氧气的氛围下进行的热处理。二条件的热处理,是以1000°c以上的温度,在含有氧气且不含有稀有气体的氛围下进行的热处理。一条件的氛围的代表例是氩气氛围(Ar气体100% )。二条件的氛围的代表例是氧气氛围(O2气体100%)。热处理温度若是不到1000°C,由于滑移位错的发生会被限制,因此无法充分获得本发明的效果。另一方面,通过设成1350°C以下的温度,能够切实地防止滑移位错大幅地增加,因此优选。
上一篇:退火炉处理后工件出炉温度不宜太高

Copyright © 丹阳市电炉厂有限公司 版权所有 www.tclthlcndlcj.com
全国服务电话:18112840006 邮箱:18912840006@189.cn
公司地址:江苏镇江丹阳市开发区开发大道168号
台车炉,回火炉,退火炉
